窒化アルミニウムセラミックは重要な放熱基板材料ですが、窒化アルミニウムセラミック基板自体は導電性がないため、高出力放熱基板として使用する前に表面を金属化する必要があります。
高温でのセラミック表面への金属の濡れ性は、金属とセラミック間の結合力を決定し、良好な結合力はパッケージング性能の安定性に対する重要な保証であるため、セラミック基板の金属化の実現は、窒化アルミニウムセラミックスの実用化の重要な部分です。

機械的接続と結合
機械的接続方法は、合理的な構造設計を採用し、機械的応力を利用して、ホットスリーブ接続やボルト接続などの窒化アルミニウム基板と金属の接続を実現することを特徴としています。機械的接続方法は、プロセスが簡単で実現性が良いという特徴がありますが、接続時の応力が大きく、高温環境に適しておらず、適用範囲が限られています。
接合とは、有機バインダーを接合媒体として、適切な接合プロセスを通じて、窒化アルミニウム基板と金属材料の性質を機械的な全体接合方法に組み合わせることを指します。ただし、この接合方法は高温、高強度の環境には適しておらず、使用範囲が狭いです。
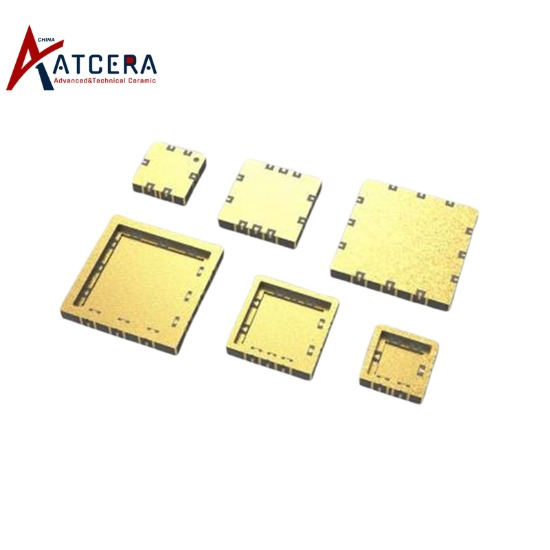
厚膜法(TPC)
厚膜法とは、スクリーン印刷により導電性ペーストを窒化アルミニウムセラミック基板の表面に直接塗布し、その後、高温で乾燥・焼結して金属コーティングをセラミック基板の表面に付着させるプロセスを指します。
導電性ペーストは、一般的に導電性金属粉末、ガラスバインダー、有機キャリアで構成されています。導電性金属粉末は、フィルム形成後のペーストの電気的および機械的特性を決定します。一般的に使用される金属粉末は、銀、銅、ニッケル、アルミニウムなどであり、そのうち銀と銅は抵抗が低く、コストが低いため、工業生産に適しています。
したがって、このプロセスは信頼性が高く、生産効率が高く、コストが低く、設計が柔軟であるなどの利点があります。欠点は、スクリーン印刷プロセスの精度によって制限され、接着力を制御するのが容易ではなく、焼結基板では高精度のラインが得られないため、ライン精度の要件が低い電子デバイスパッケージング材料にのみ適用できることです。
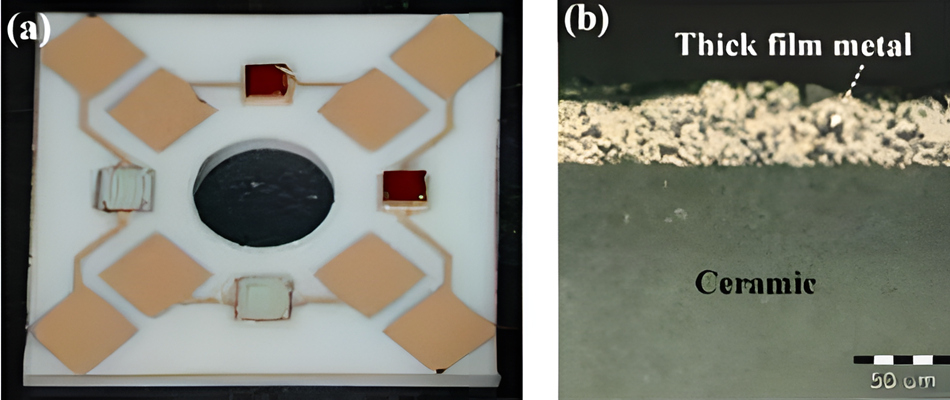
活性金属ろう付け(AMB)
活性金属ろう付け法は、Ti、Zr、Al、Nb、Vなどの比較的活性な化学的性質を持つ遷移元素を一般的なろう付け金属に直接添加する方法です。これらの活性元素は、窒化アルミニウムセラミックの表面と直接化学反応を起こして遷移層を形成します。遷移層の主な生成物はいくつかの金属結合化合物であり、金属と同じ構造を持っているため、溶融したフィラー金属によって濡れて冶金接合部を形成できます。
窒化アルミニウムセラミック基板は重要な放熱装置であり、高温で使用されることが多いため、より多くの高温接合部が必要です。CuTiとNiTiを主成分とする高温活性ろう材は、1200〜1800℃の範囲で使用できます。Auベース、Coベース、PDベースのろう材に代表される三元系または多成分系のろう材は、最も一般的に使用される高温活性ろう材です。Au、Co、Pdの融点はそれぞれ1064℃、1492℃、1554℃であり、ろう材の融点を上げる役割を果たしています。
ろう付け金属中の活性元素は化学的に活性であるため、高温での酸素との化学反応を避けるために、活性ろう付けは厳しい真空環境または不活性雰囲気の保護下で実施する必要があり、技術コストが高く、大規模な用途には適していません。